Time-of-Flight Sekundärionen-Massenspektrometrie
TOF-SIMS (Time-of-Flight Sekundärionen-Massenspektrometrie) ist eine hochauflösende, bei Bedarf bildgebende Analysemethode zur Charakterisierung von Festkörperoberflächen. Diese Technik ist eine Variante der TOF-Massenspektrometrie. Aus der Analyse von Sekundärionen liefert es Informationen über die lokale chemische Zusammensetzung der Probe mit einer lateralen Auflösung im Submikrometerbereich. Die Rasterung des Primärionenstrahls über die Probenoberfläche ermöglicht dabei die Darstellung der Massenverteilung und der Zusammensetzung der Probenoberfläche in einem sogenannten Massebild. Im Gegensatz zu NanoSIMS, arbeitet ToF-SIMS nicht mit einem Sektorfeld-Massenspektrometer, sondern mit Flugzeitmessungen.
Wurden bei den ersten SIMS-Geräten noch Quadrupole in den ersten SIMS-Geräten verwendet wurden, gelten diese heute aufgrund der sequentiellen Abfragemethode der Quadrupol-MS als veraltet. Magnetisch Bereich Feldmassenspektrometer haben auch systembedingte Einschränkungen, was bedeutet, dass flugzeitbasierte Methoden immer beliebter werden, da mit jedem Impuls des Systems das komplette Massenspektrum aufgezeichnet werden kann. TOF-Messungen basieren auf der Trennung beschleunigter Ionen in einem elektrischen Feld entsprechend ihrem Verhältnis von Masse zu Ladung, das auf der Flugzeit entlang einer feldfreien Driftbahn basiert.
ToF-SIMS ist besonders gut geeignet für die Analyse der obersten Atomlagen und ermöglicht zudem auch hyperspektrale, dreidimensionale Bildgebung für räumlich aufgelöste Materialanalysen von Oberflächen, Dünnschichten und Grenzflächen der untersuchten Proben (Tiefenprofilierung). Dabei können sowohl leitende als auch isolierende Materialien analysiert werden, die einzige Voraussetzung ist, dass die Probe in ein Vakuum eingebracht werden kann.
Für verschiedenste Mikrostrukturanalysen von Festkörpern, Flüssigkeiten und pastösen Materialien bietet ToF-SIMS eine ausgezeichnete Spezifität. Dabei handelt es sich zwar um eine destruktive Methode, bei welcher die untersuchte Oberfläche teilweise abgebaut wird, diese gilt jedoch aufgrund der geringen Anzahl der Primärionen pro Flächeneinheit als nahezu zerstörungsfrei.
Funktionsweise:
Bei der ToF-SIMS-Analyse werden Primärteilchen (zumeist entweder Kationen oder Anionen eines Inertgases) auf die Probenoberfläche geschossen (mit kinetischer Energie im höheren KeV-Bereich bis in den MeV-Bereich hinein), wobei in der Regel die Oberfläche in einem Raster bearbeitet wird. Der Ionenstrahl selbst kann dabei auf einen Bereich mit einem Durchmesser von weniger als 0,1 Mikrometer fokussiert werden. In einigen Fällen durchlaufen die Ionen dabei einen Wien filter und haben somit die gleiche Geschwindigkeit. Beim Auftreffen dringen (sofern die eingebrachte Energie groß genug ist) die Ionen in die Probe ein und übertragen ihre kinetische Energie an die Teilchen der ersten Lage, wobei diese Impulsübertragung die Gitteratome (bzw. Moleküle) der Probe stört. Damit wird im Probenmaterial eine Stoßkaskade ausgelöst, wobei einige Teilchen ausreichend Energie erhalten, um aus dem Probenmaterial emittiert zu werden (sputtering). Die Ionenausbeute variiert bei den verschiedenen Elementen um mehrere Größenordnungen. Die Ausbeute an Sekundärionen, die beim Sputtern von organischen und anorganischen Materialien erzeugt werden, ist in den meisten Fällen sehr gering, wobei es sich bei den am häufigsten ausgestoßenen Fragmenten um neutrale Teilchen handelt.
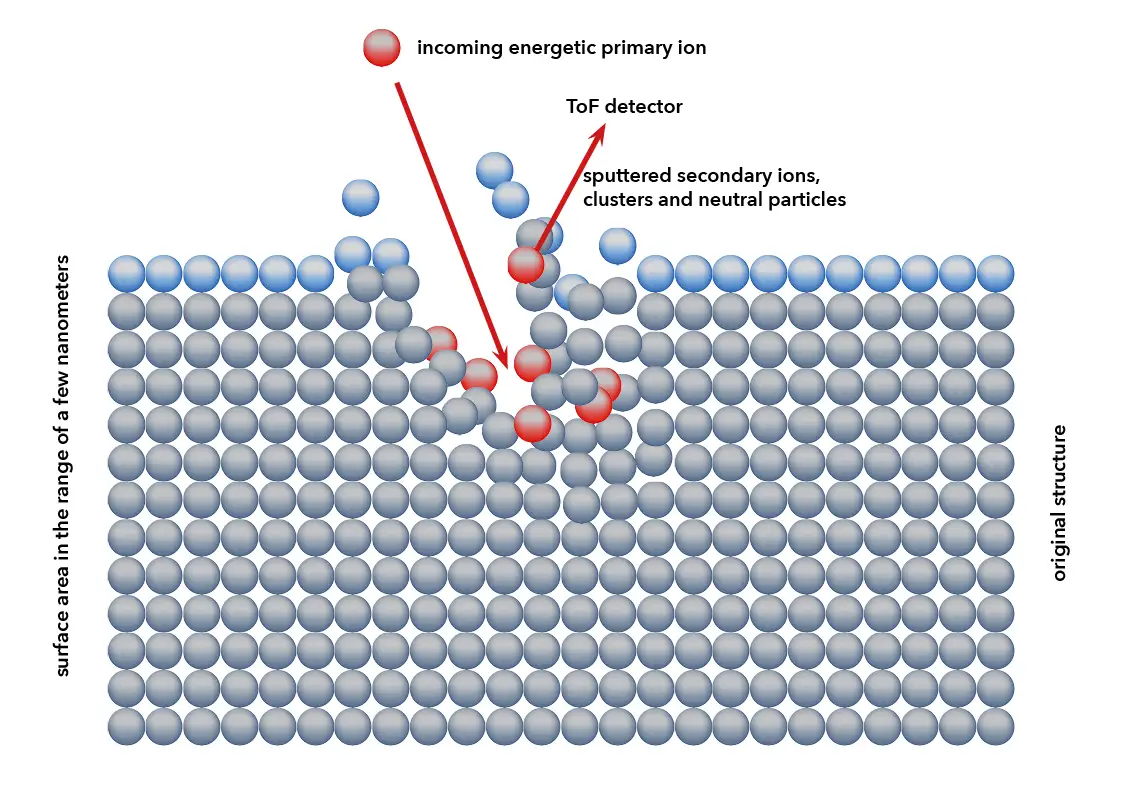
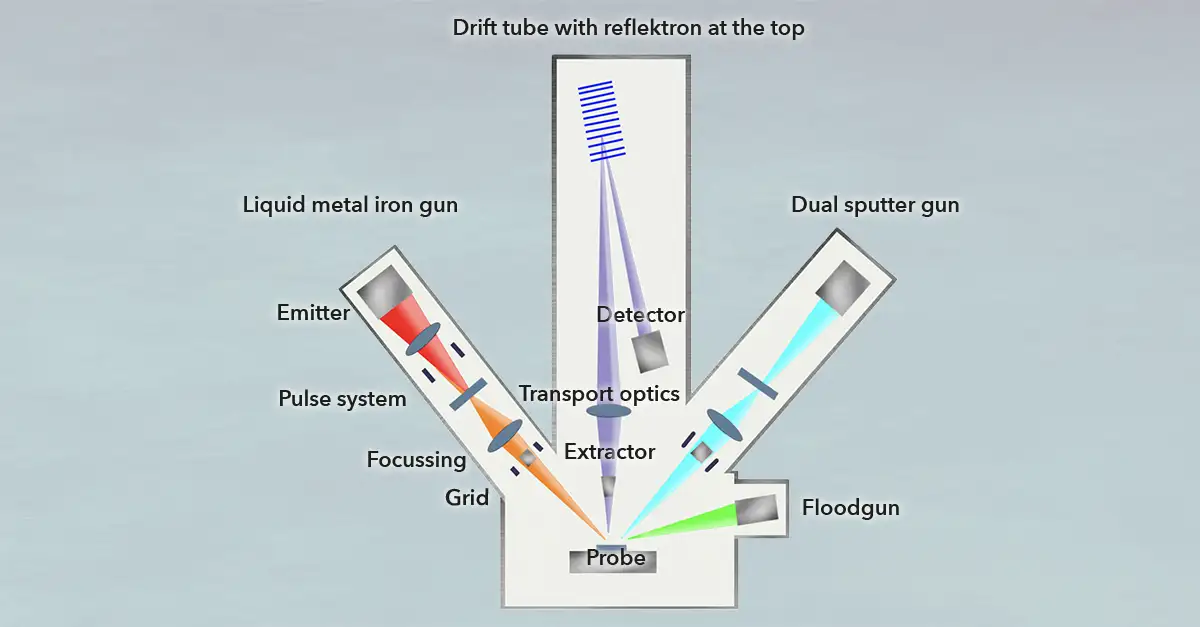
Beschreibung der Elemente eines ToF-SIMS-Gerätes:
- Die Herstellung von Primärionen erfolgt häufig durch Elektrospay-Ionisation. Dafür kommt eine sogenannte Flüssigmetallionenquelle (Liquid Metal Ion Gun, LMIS, LMIG) zum Einsatz, die meist einen Sondendurchmesser im Mikrometerbereich aufweist. Dabei wird eine Analytlösung durch eine Metallkapillare geleitet, an deren Spitze eine Spannung angelegt ist. Somit kommt es zur Bildung eines elektrischen Feldes zwischen der Kapillare und einer Gegenelektrode, womit ein fokussierter Ionenstrahl erzeugt wird. Ga-Ionen eignen sich für die Analyse von Bereichen mit geringer Masse (hauptsächlich Elemente), während Au- und Bi-Ionen für Bereiche mit hoher Masse (hauptsächlich Moleküle) geeignet sind.
- Sekundärionen, die von einer festen Oberfläche emittiert werden, haben eine Energieverteilung von mehreren eV bis zu mehreren Dutzend eV und einen großen Emissionswinkel, was selbst bei gleicher Ionenmasse zu Unterschieden in der Ankunftszeit am Detektor führen kann. Diesem Problem kann mit einem Wien filter hinter der Ionenquelle begegnet werden, der eine Massentrennung durch Impulsablenkung ermöglicht. Dieser besteht aus einer statischen Ablenkung (statische Hochspannung) für den Ionenstrahl und einem 90°-Pulser (gepulste Hochspannung), und trägt dazu bei, nur diejenigen Teilchen den Filter passieren zu lassen, die eine bestimmte Geschwindigkeit besitzen.
- Im sogenannten Buncher wird zeitverzögert eine zusätzliche Spannung eingebracht, sodass eine weitere Bündelung der Primärionenpulse erfolgt. Diese Maßnahme führt zu einer effizienten Reduktion der Pulsbreite.
- Die Primär-Ionenstrahlen treffen im (hier vergößert dargestellten) Target auf die Probe und löst in der obersten Lage des Probenmaterials eine Stoßkaskade aus (sputtering).
- Zum Ladungsausgleich werden bei der Messung isolierender Materialien Primärionen gleichzeitig von einer Flood Gun mit gepulsten niederenergetische Elektronen bestrahlt, um eine Aufladung der Probe durch die Primärionenbestrahlung zu vermeiden.
- Für die Auswertung tieferer Bereiche kann ggF. zusätzlich zur Primär-Ionenkanone eine Sputter-Ionenkanone verwendet werden um gezielt Materialschichten abzutragen. Im Allgemeinen werden dazu Sauerstoff- (02) und Cäsium- (Cs) Ionen für die Tiefenprofilanalyse von anorganischen Materialien wie Metallen und Halbleitern eingesetzt. Fullerene (C60) und Argon-Gas-Cluster-Ionen (Ar-GCIB) hingegen werden für organische Materialien verwendet.
- Die Sekundärionen werden in die Driftstrecke des Flugzeit-Massenspektrometers beschleunigt. Das Reflektron am oberen Ende der Driftstrecke verlängert die Flugstrecke.
Laser SNMS:
Die Empfindlichkeit von ToF-SIMS Messungen kann darüberhinaus ggf. mittels Laser SNMS erhöht werden. Dabei werden die gesputterten neutralen Spezies mit einem Laserpuls nachionisiert, womit das Signal-Rauschverhältnis der ToF-SIMS-Messung noch einmal deutlich erhöht wird. Dabei wird der Nachweis großer organischer Ionen aufgrund der Photofragmentierung jedoch ggf. erschwert. Laser-SNMS bietet eine höhere Empfindlichkeit für neutrale Atome und eignet sich besonders für präzise quantitative Analysen, während TOF-SIMS insbesondere in der qualitativen chemischen Oberflächenanalyse und Bildgebung seine Vorteile aufweist.
Datenakquise:
Als Detektoren werden verwendet:
- MCPs
- Sektorfeld Detektoren
- Orbitraps
- Hybrid Photodetektoren
- Sekundärelektronenvervielfacher (SEV)
- Halbleiterdetektoren, wie z.B. SPADs oder APDs
Üblicherweise wird in einem Massenbild die Intensitätsverteilung einer ausgewählten Masse dargestellt wobei über die Interpretation der resultierenden Massenspektren auf die vorhandenen Materialien geschlossen wird. Die Zählrate für jedes Pixel des Bildes wird durch einen Helligkeitswert angegeben. Moderne ToF-SIMS-Geräte erreichen maximale laterale Auflösungen von bis zu 60 nm für geometrisch ebene, leitende Proben. Diese Grenze ist durch den Durchmesser des primären Ionenstrahls gegeben.

Anwendungen:
Mittels ToF-SIMS können verschiedenste Materialien, wie Metalle, Keramik, Gläser oder Kunststoffe, Leitfähige und isolierende Substrate, Pulver oder Fasern untersucht werden. Glatte Oberflächen sind dabei von Vorteil.
- Im Rahmen der Materialwissenschaften ist TOF-SIMS eine häufig angewendete Technik zur Charakterisierung von Dünnschichten und Nanomaterialien, Materialoberflächen und -schnittstellen. Dabei werden z.B. Metalle, Legierungen, Keramiken, optische Bauteile, Beschichtungen, Papier, Farben, Diffusionsprozesse, katalytische Feststoffe oder Korrosionsprodukte analysiert.
- Bei der Qualitätssicherung für Industrieprozesse kann mittels ToF-SIMS Messungen der Nachweis von Kontaminationen erfolgen, in Kompositmaterialien die Schichthomogänität kontrolliert und ggF. Schichtschluss nachgewiesen werden. Eine der verbreitetesten Anwendungen liegt in der eindeutigen Identifizierung organischer Verbindungen an Oberflächen (z.b. von Silikonen/Silikonölen, PDMS, Fetten/Ölen oder Klebstoffrückständen). Es können auch verschiedenste Polymerschichten untersucht werden und dabei z.B. auch Alterungsprozesse in Polymeren erfasst werden. Die Charakterisierung von katalytischen Materialien, die Untersuchung von Adsorptions- und Desorptionsprozessen und die Analyse von chemisch modifizierten Oberflächen (z.B. die Analyse von Oberflächenbeschichtungen auf Geweben) sind ebenso möglich wie die Identifikation von anorganischen bzw. metallischen Verunreinigungen und die Bestimmung der Oberflächenzusammensetzung von Legierungen.
- In der Halbleiterindustrie werden Verunreinigungen, Defekte und Schichtzusammensetzungen untersucht um die Kontrolle und Optimierung der Produktion zu gewährleisten. Dabei werden z.B. im Rahmen der Verunreinigungsanalyse dünne Oxid- und Nitridschichten auf atomarer Ebene identifiziert und es können Tiefenprofile von Dotierstoffen erstellt werden. Das Oberflächenmapping mittels ToF-SIMS dient dabei z.B. der Kontrolle von Bondkontakten und Beschichtungen.
- Zur Untersuchung der Verteilung von Wirkstoffen und Hilfsstoffen in der pharmazeutischen Industrie wird mit dieser Technik (z.B. im Rahmen der Untersuchung von Wirkstofffreisetzungssystemen) die Medikamentenverteilung in Geweben ermittelt. Zudem können im Rahmen der Qualitätskontrolle Beschichtungen auf Tabletten charakterisiert werden.
- TOF-SIMS dient Biowissenschaftlern vornehmlich der Erforschung von Biomolekülen in Geweben und Zellen, sodass z.B. Lipid- und Proteinverteilungen untersucht werden können.
- In den Geowissenschaften dient ToF-SIMS vornehmlich der Analyse von geologischen Prozessen, Mineralien und Gesteinen, z.B. bei der Untersuchung von extraterrestrischen Proben.
- Die Forensik nutzt diese Untersuchungsmethode zur Spurenanalyse von Sprengstoffen, Drogen und anderen chemischen Rückständen und identifiziert derartige Spuren an Tatorten.
- Tof-SIMS wird auch genutzt, um Farbpigmenten und Materialien in Kunstwerken zu untersuchen, um z.B. die Alterung und Konservierung von historischen Artefakten zu bestimmen.
- Umweltwissenschaftler nutzen ToF-SIMS für die Analyse von Schadstoffen und deren Verteilung in der Umwelt z.B. in Böden und Sedimenten.
Vorteile der ToF-SIMS:
- Erfolgen SIMS-Analysen mit Hilfe von Flugzeitmessung, so wird der verfügbare Massenbereich etwa um das Zehnfache im Vergleich zu Quandrupol-basierten Messungen erweitert. Damit wird es möglich, sehr kleine Mengen von Materialien auf der Oberfläche der Probe zu erkennen.
- Hohe Empfindlichkeit: ToF-SIMS kann sehr niedrige Konzentrationen von Elementen und Molekülen nachweisen, oft im Bereich von wenigen ppm oder sogar im sub-ppm-Bereich.
- Bei SIMS-Analysen gibt es keine theoretische Massenobergrenze
- Alle Massen können innerhalb eines Analysezyklus nachgewiesen werden.
- Hohe laterale Auflösung: Diese Technik ermöglicht die Untersuchung sehr kleiner Bereiche (bis in den Nanometerbereich < 100 nm) und kann 2D- oder 3D-Bilder der chemischen Zusammensetzung von Proben erstellen.
- Breites Anwendungsspektrum: Die Messung kann auf eine Vielzahl von Materialien angewendet werden, einschließlich organischer und anorganischer Proben. Von allen aktuellen Oberflächenanalyseverfahren ist SIMS das einzige Verfahren, welches für alle Elemente empfindlich ist.
- Kontaminationsfreie Präparation und Analyse von Querschnitten mittels dynamischem ToF-SIMS
Einschränkungen von ToF-SIMS:
- Ein klarer Nachteil von ToF-SIMS ist die möglicherweise hohe Fragmentierungsrate der Zielmoleküle. Denn bei der Analyse organischer Ablagerungsspezies z.B. ergeben sich extrem komplexe Massenspektren, die ein unvermeidliches Untergrundniveau über das gesamte Massenspektrum hinweg aufweisen. Dies erschwert ggF. die Identifikation der Ausgangsmoleküle.
- Die Entstehung von Sekundärionen hängt in hohem Maße von ihrer chemischen Umgebung ab. Aufgrund der Abhängigkeit der Ionisierungswahrscheinlichkeit von der umgebenden Matrix handelt es sich bei ToF-SIMS lediglich um eine semi-quantitative Methode. Eine Quantifizierung ist lediglich durch den Vergleich der Spektren mit Standardproben bekannter Zusammensetzung möglich.
- Die Empfindlichkeitsschwankungen bei SIMS sind extrem hoch. Die elektropositiven Elemente weisen dabei meist eine höhere Empfindlichkeit bei der SIMS mit positiven Primärionen und die elektronegativen Elemente weisen eine höhere Empfindlichkeit bei der SIMS mit negativen Primärionen auf.
- Möglicherweise erfolgt eine Reduktion von organischen Oberflächenspezies durch freigesetzte Sekundärelektronen. Bei sehr niedrigen Ionendosen ist dieser Effekt jedoch meist vernachlässigbar.

Anmerkung:
Dieser Artikel über die Anwendungen der Flugzeit-Sekundärionen-Massenspektrometrie für unsere Produkte wurde durch den Beitrag von Polina Fraatz über den zerstörten Reaktor in Tschernobyl inspiriert, die uns freundlicherweise die Erlaubnis zur Verwendung des gezeigten Bildmaterials erteilt hat. Wir möchten den Besuchern unserer Website, die sich für solche Themen interessieren, einen kleinen Einblick in diverse Anwendungen zu unseren Produkten geben. Wir selbst beschäftigen uns in erster Linie mit den Anforderungen unserer Kunden an die Datenerfassung und sind keine Chemiker, Biologen oder Mediziner und bauen auch keine Massenspektrometer oder bildgebenden Systeme. Die folgenden Inhalte sind jedoch nicht als wissenschaftliche Abhandlung zu verstehen, sondern spiegeln auch subjektive Eindrücke wider.